作者:德州儀器 Aleksandras_Kaknevicius
從智慧型手機到汽車,消費者持續要求在越來越精巧的產品中納入更多功能。為了協助因應這項趨勢,TI 針對半導體裝置打造最出色的封裝技術,包括用於子系統控制及供電順序的負載開關。封裝創新技術能夠提升功率密度,以便在每個印刷電路板納入更多半導體裝置及功能。
晶圓晶片規模封裝 (WCSP)
目前市面上尺寸最小的負載開關就是採用晶圓晶片規模封裝 (WCSP)。圖 1 為四接腳 WCSP 裝置範例。

圖 1:四接腳 WCSP 裝置
WCSP 技術將矽晶粒及錫球裝設在底部,因此可實現最小尺寸,並在電流輸送及封裝面積等方面具備競爭力。由於 WCSP 盡可能縮小外型規格,因此用於輸入和輸出接腳的錫球數量,會限制負載開關能夠支援的最大電流。
塑膠封裝搭配打線接合技術
電流較高的應用,或是工業 PC 等製程較為嚴苛的應用,需要實作塑膠封裝。圖 2 為採用打線接合技術實作的傳統塑膠封裝。
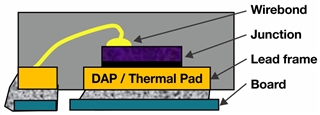
圖 2:標準打線接合四方扁平無導線 (QFN) 封裝
QFN 或小外形封裝無導線 (SON) 封裝採用打線接合技術將晶粒連接導線,可讓更多電流從輸入傳送至輸出,同時針對自熱效應提供良好的熱特性。不過相較於晶粒大小,打線接合塑膠封裝需要為接合線提供大量空間,因此必須使用更大的封裝。接合線也會對電源路徑增加電阻,造成負載開關產生更高的總導通電阻。因此其中需要在更大尺寸及支援更高功率之間做出取捨。
塑膠 HotRod 封裝
WCSP 及打線接合封裝各有優點及限制,而 TI 的 HotRod QFN 負載開關則結合了前述兩項封裝技術的優點。圖 3 為 HotRod 封裝分解圖。
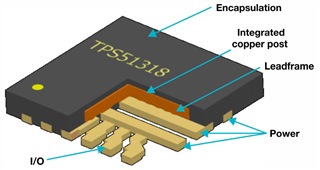
圖 3:TI HotRod QFN 結構和晶粒接合
這類無導線塑膠封裝使用銅柱將晶粒連接封裝,所需面積小於接合線,因此可以盡量縮小封裝尺寸。銅柱也支援高電流位準,並盡可能減少對電源路徑增加的電阻,最多可讓 6A 電流通過單一接腳。
表 1 比較 TPS22964C WCSP、TPS22975 打線接合 SON 及 TPS22992 負載開關,藉此說明以上優點。
|
產品及封裝尺寸 |
TPS22964C WCSP |
TPS22975 打線接合 SON |
TPS22992 HotRod 封裝 |
|
輸入電壓 |
1 V 至 5.5 V |
0.6 V 至 5.7 V |
0.1 V 至 5.5 V |
|
最大電流 |
3 A |
6 A |
6 A |
|
導通電阻 |
13 mΩ |
16 mΩ |
8.7 mΩ |
|
可調整上升時間 |
否 |
是 |
是 |
|
電源良好訊號 |
否 |
否 |
是 |
|
可調整快速輸出放電 |
否 |
否 |
是 |
|
解決方案尺寸 |
1.26 mm2 |
4 mm2 |
1.56 mm2 |
表 1:比較各種負載開關解決方案
雖然 TPS22975 打線接合 SON 裝置也能支援 6A 電流,但是要達到這樣的電流位準,代表輸入及輸出電壓各需要使用兩個接腳,會對額外功能的數量造成限制,例如電源良好及可調整上升時間。接合線也會增加裝置的導通電阻,對最大電流造成限制。
WCSP 負載開關是三種解決方案最小的一種,不過接腳數量有限,因此功能數量最少,支援的電流也最低。
結論
TPS22992 負載開關結合 WSCP 及 SON 的優勢,除了具備 WCSP 解決方案的小尺寸優勢,也提供打線接合 SON 解決方案的高電流支援及額外功能。TI 的 TPS22992 及 TPS22998 負載開關使用 HotRod 封裝,打造最佳化的小型解決方案尺寸,同時支援高電流、低導通電阻及眾多裝置功能。
其他資料來源
- 請參閱技術白皮書:「何時讓開關成為整合式負載開關」。
- 利用應用報告深入瞭解負載開關:「負載開關基本說明」。
- 利用電子書探索設計秘訣:「保護電源路徑的 11 種方式」。
- 請參閱應用報告:「強化 HotRod QFN 封裝:在業界最小的 4-A 轉換器實現低 EMI 效能」。
- 請查看 TI QFN 及 WCSP 封裝解決方案。
