GaN (窒化ガリウム) FET (電界効果トランジスタ) には、効率を向上させ電源のサイズを縮小する特長があり、採用が急速に広まっています。ただし、この技術に投資する前にGaN の信頼性に関して疑問を抱く方もいることでしょう。一方でシリコンに対しては「信頼できるか」と尋ねる人がいない事実も思い浮かびます。結局、新しいシリコン製品は今も継続的に登場しており、電源設計者はシリコン製パワー・デバイスの信頼性にも注意を払っています。
GaN 関連業界は信頼性に関してかなりの労力と時間を費やしてきました。
シリコンの場合、信頼性を問う際には「この製品は認証済みかどうか」という表現がされます。GaN 製パーツがシリコンの認証に合格したとしても、シリコンと同じ手法で「信頼できる GaN FET である」という保証が得られるわけではないので、電源メーカーは納得できません。シリコン・デバイス向けのすべてのテストを GaN に適用できるわけではないため、これは適切な観点です。従来のシリコン認証自体は、電源使用時の実際のスイッチング条件に対応するストレス・テストを実施しません。JEDECの JC-70 Wide Bandgap Power Electronic Conversion Semiconductors committee (ワイド・バンドギャップ・パワー・エレクトロニクス変換半導体委員会)は、この規格不足に対処するために、GaN 固有のガイドラインをいくつか策定してきました。
| GaN 製品の信頼性に関する理解を深める | |
| GaN の信頼性に関連する TI のテストの詳細については、技術ホワイト・ペーパー『Achieving GaN Products with Lifetime Reliability』 (英語) をご覧ください。 | |
どうすれば GaN の信頼性を検証できるか?
GaN FET の信頼性を検証するには、確立済みのシリコンの手法に対し、動的なドレイン - ソース間オン抵抗 (RDS(ON)) の増加など GaN 固有の故障モードに取り組む目的で策定された信頼性手順と複数のテスト手法を組み合わせます。図 1 に、信頼性の高い GaN 製品を実現するための手順を示します。
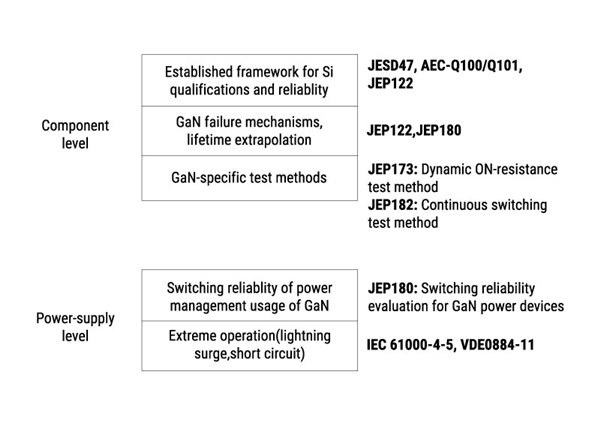 図 1:確立済みのシリコン向け規格と組み合わせる、信頼性に関する GaN 固有のガイドライン
図 1:確立済みのシリコン向け規格と組み合わせる、信頼性に関する GaN 固有のガイドライン
TI では各テストをコンポーネント・レベルのブロックと電源レベルのブロックに分類し、各ブロックに対して関連する規格とガイドラインを割り当てました。コンポーネント・レベルでは、従来のシリコン向け規格に従ってバイアス、温度、湿度に関するストレス・テストを実施します。また、GaN 固有のテスト方式を使用し、デバイスが故障するまで加速型のストレスを印加する方法で寿命を判定します。電源レベルでは、該当するアプリケーションに合わせて、厳格な動作条件の下でパーツを動作させます。また、偶発的な現象に起因する極端な動作条件の下でも堅牢性を検証しています。
アプリケーションでの GaN FET の信頼性
JEDEC の JEP180 ガイドラインは、電力変換アプリケーション内での GaN 製品の信頼性を保証するための一般的なアプローチを規定しています。JEP180 に適合するために、GaN 製品のメーカーは自社の製品が、該当するストレスの下で所定のスイッチング寿命を達成すること、および電源内での厳格な動作条件の下で高い信頼性を維持して動作することを実証する必要があります。前者を実証するには、スイッチングに関する加速型寿命試験 (Switching Accelerated Lifetime Testing:SALT) を使用し、デバイスにストレスを加えて故障を発生させます。後者には動的高温動作寿命 (Dynamic High-Temperature Operating Life:DHTOL) 試験を使用します。
またデバイスは、短絡や電力線 (商用電源) サージのような実世界の極端な動作条件にもさらされます。『LMG3522R030-Q1』のような TI の GaN 製品は、短絡保護機能を内蔵しています。一連のアプリケーションを対象とするサージ堅牢性は、ハード・スイッチングとソフト・スイッチング両方のストレスに関する検討事項を踏まえています。GaN FET は、シリコン FET とは異なる方法で電力線サージに対処します。シリコン製品がアバランシェ・ブレークダウン状態に移行するのとは異なり、GaN FET は過電圧対処能力を使用して、サージによる影響をやり過ごします。過電圧対処能力は、システムの信頼性向上にも役立ちます。シリコン製品の場合、FET のアバランシェで大量のアバランシェ・エネルギーを吸収することはできないため、保護回路がサージの大半を吸収する必要が生じるからです。サージ吸収コンポーネントの経年劣化に伴い、シリコン FET はより高いレベルのアバランシェにさらされ、故障に至る可能性があります。それに対し、GaN FET はスイッチングを継続します。
TI の GaN 製品の信頼性
TI では、図 1 に示す手法に従って自社の GaN 製品の適格性試験を実施しています。図 2 は、その結果を要約したもので、コンポーネント・レベルと電源レベル両方のブロックから得られた結果を示しています。
 図 2:図 1 に示した手法を使用し、GaN 固有のガイドラインに沿って GaN FET の信頼性を検証
図 2:図 1 に示した手法を使用し、GaN 固有のガイドラインに沿って GaN FET の信頼性を検証
コンポーネント・レベルで TI の GaN 製品は従来のシリコン向け認証に合格しているほか、GaN 固有の故障メカニズムに関しても高い信頼性を示しています。TI は、時間依存のブレークダウン (Time-Dependent Breakdown:TDB)、電荷トラップ、ホット・エレクトロン (高温電子) による劣化といった故障メカニズムに対して、高い信頼性の確立と検証を実施しているほか、動的 RDS(ON) が経年的に安定していることを実証しています。
コンポーネントのスイッチング寿命を判定するために、TI の SALT 検証では『A Generalized Approach to Determine the Switching Lifetime of a GaN FET』 (英語) に示す方法で、加速型のハード・スイッチング・ストレスを印加しています。TI のモデルはスイッチング波形を使用してスイッチング寿命を直接計算し、製品の寿命全体を通じて TI の GaN FET がハード・スイッチング・ストレスによって故障することはないという結論を示しています。
電源レベルの信頼性を検証するために、厳格な電源使用条件の下で 64 個の GaN 製パーツに対して DHTOL (動的高温動作寿命) 試験を実施しました。これらのデバイスは安定した効率を示し、ハード故障も発生しないことから、電源動作のすべてのモードで信頼できる動作を実証しています。すべてのモードとは、ハード・スイッチングとソフト・スイッチング、第 3 象限動作、ハード整流 (逆回復)、高スルーレートの Miller 貫通電流、ドライバと他のシステム・コンポーネント間の信頼性の高い相互作用を意味します。加えて、ハード・スイッチングとソフト・スイッチングそれぞれの動作状態にある電源を使用して動作しているデバイスに対してサージの衝撃を印加する方法で、サージ堅牢性も検証しました。TI の GaN FET は、最大 720V に達するバス電圧のサージを効果的にやり過ごせることを示しましたが、この値は十分なマージンを確保できることになります。このテストの詳細については、『A New Approach to Validate GaN FET Reliability to Power-Line Surges Under Use Conditions』 (英語) をご覧ください。
まとめ
GaN 関連業界は GaN 製品の信頼性を保証するための手法を確立してきました。したがって「GaN は信頼できるか?」ではなく、「どうすれば GaN の信頼性を検証できるか?」という点を問うべきです。TI の各種 GaN デバイスは、コンポーネント・レベルと実世界のアプリケーションの両方で信頼性を確保しています。これらの製品は、シリコン向け認証の基準と、GaN 関連業界が策定したガイドラインの両方に合格済みです。特に、TI の各種 GaN 製品は JEP180 に合格し、電源サージが発生した場合でも信頼できることを実証しています。
参考情報:
+TI の GaN 製品ラインアップ
+GaN 技術の利点
※すべての登録商標および商標はそれぞれの所有者に帰属します。
※上記の記事はこちらの技術記事(2022年4月21日)より翻訳転載されました。
※ご質問はE2E Support Forumにお願い致します。
